Plasma Etch Chambers
Plasma
etch system
- It
is used to etch silicon and its compounds with fluorine-containing gas
such as CF4 as the etchants, with SiF4 as the
gaseous etch byproducts.
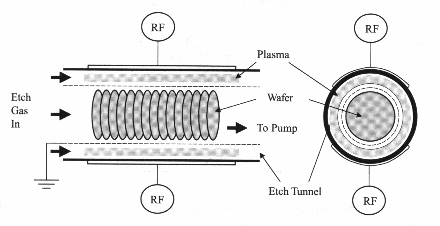
Fig.7 (a) Schematic of a barrel
etch system [3]
Down-stream
or Remote plasma system
- It
generates plasma in a remote chamber.
- The
etchant gases are allowed to flow through the plasma chamber and
dissociate into the plasma, and the free radicals are allowed to flow to
the process chamber to react with and etch the materials on the wafer. [3]
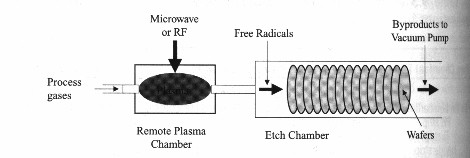
Fig.7 (b) Schematic of a
down-stream plasma etch system [3]
Note: The barrel and downstream systems are designed as
isotropic etch systems. Following systems were developed to get a
directional/anisotropic etch.
Parallel
Plate Plasma etch system
- It
operates at about 0.1 to 10 Torr and the wafer sits on the grounded
electrode.
- To
increase etch rate and improve the directional etch, we need to increase
ion bombardment by increasing RF power and by reducing pressure.
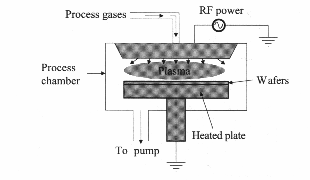
Fig. 7 (c) Schematic of the parallel plate plasma etch
system.[3]
Batch
Reactive Ion Etch System
- Here
an RF-driven electrode instead of the grounded electrode holds the wafer.
This allows the grounded electrode to have a significantly larger area
because it is in fact the chamber itself.
- This
larger grounded area combined with the lower operating pressures leads to
significantly higher plasma-sheath potentials at the wafer surface, which
results in higher energy ion bombardment.
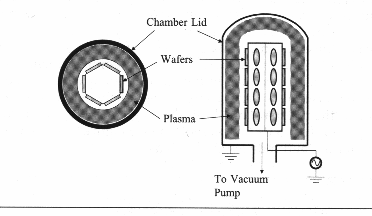
Fig 7 (d) Schematic of a batch RIE system [3]
Single-wafer
Magnetically enhanced (MERIE) system
- As
device dimensions shrink; the requirements for etch uniformity become more
stringent.
- Single
wafer process tools, which have better wafer-to-wafer process control
become important, for example, MERIE system.
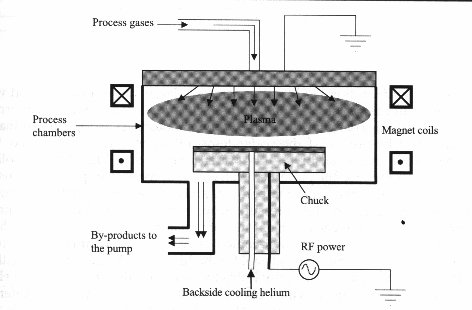
Fig. 7(e) Schematic of single-wafer MERIE system [3]